标签:
摘要: 随着消费者对更小、更快要求的进一步加强,在解决密度日益提高的印刷电路板(PCB)散热问题方面出现了艰巨的挑战。随着堆叠式微处理器和逻辑单元达到GHz工作频率范围,高性价比的热管理也许已经成为设计、封装和材料领域的工程师亟需解决的最高优先级问题。制造3D IC以获得更高的功能密度已经成为当前趋势,这进一步增加了热管理的难度。仿真结果表明,温度上升10℃会使3D IC芯片的热密度翻一倍,并使性能降低三
随着消费者对更小、更快要求的进一步加强,在解决密度日益提高的印刷电路板(PCB)散热问题方面出现了艰巨的挑战。随着堆叠式微处理器和逻辑单元达到GHz工作频率范围,高性价比的热管理也许已经成为设计、封装和材料领域的工程师亟需解决的最高优先级问题。
制造3D IC以获得更高的功能密度已经成为当前趋势,这进一步增加了热管理的难度。仿真结果表明,温度上升10℃会使3D IC芯片的热密度翻一倍,并使性能降低三分之一以上。
微处理器的挑战
国际半导体技术蓝图(ITRS)的预测表明,在今后三年内,微处理器内难以冷却区域中的互连走线将消耗高达80%的芯片功率。热设计功耗(TDP)是评估微处理器散热能力的一个指标。它定义了处理器达到最大负荷时释放出的热量以及相应的壳温。
Intel和AMD公司最新微处理器的TDP在32W至140W之间。随着微处理器工作频率的提高,这个数字还会继续上升。
拥有数百个计算机服务器的大型数据中心特别容易遭遇散热问题。根据一些估计数据,服务器的冷却风扇(可能消耗高达15%的电能)实际上已经成为服务器中及其本身的一个相当大的热源。另外,数据中心的冷却成本可能占数据中心功耗的约40%至50%.所有这些事实对局部和远程温度检测及风扇控制提出了更高的要求。
热量管理挑战在遇到安装包含多内核处理器的PCB时将变得更加艰巨。虽然处理器阵列中的每个处理器内核与单内核处理器相比可能消耗较少的功率(因而散发较少的热量),但对大型计算机服务器的净效应是给数据中心的计算机系统增加了更多的散热。简言之,在给定面积的PCB板上运行更多的处理器内核。
另外一个棘手的IC热管理问题涉及到芯片封装上出现的热点。热通量可以高达1000W/cm2,这是一种难以跟踪的状态。
PCB在热管理中发挥着重要作用,因此需要热量设计版图。设计工程师应该尽可能使大功率元件相互间隔得越远越好。另外,这些大功率元件应尽可能远离PCB的角落,这将有助于最大化功率元件周围的PCB面积,加快热量散发。
将裸露的电源焊盘焊接到PCB上是常见的做法。一般来说,裸露焊盘类型的电源焊盘可以传导约80%的通过IC封装底部产生并进入PCB的热量。剩下的热量将从封装侧面和引线散发掉。
散热帮手
设计工程师现在可以向许多改良的热管理产品寻求帮助。这些产品包括散热器、热导管和风扇,可以用来实现主动和被动的对流、辐射和传导冷却。即使是PCB上安装芯片的互连方式也有助于减轻散热问题。
例如,用于将IC芯片互连到PCB的普通裸露焊盘方法可能会增加散热问题。当把裸露的路径焊接到PCB上时,热量会很快逸出封装并进入电路板,然后通过电路板的各个层散发进周围的空气。
德州仪器(TI)发明了一种PowerPAD方法,能把IC裸片安装到金属盘上(图1)。这个裸片焊盘将在制造过程中支撑裸片,并作为良好的散热路径将热量从芯片中散发出去。
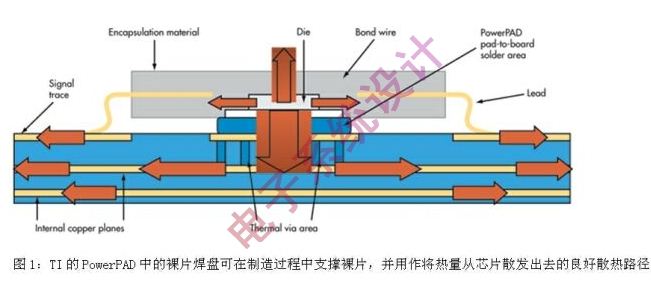
TI公司的模拟封装产品经理Matt Romig指出,TI的PowerStack方法是第一种可以堆叠高侧垂直MOSFET的3D封装技术。这种技术将由铜夹固定位置的高侧和低侧MOSFET整合在一起,并使用地电位的裸露焊盘提供热优化设计(图2)。采用两个铜夹连接输入和输出电压引脚可以形成更高集成度的扁平方形无引线(QFN)封装功率器件的热量管理具有更大的挑战性。更高频率的信号处理和缩小封装尺寸的需求使传统冷却技术逐渐边缘化。Advanced Thermal Solutions公司总裁兼首席执行官Kaver Azar建议使用带水冷式微通道的嵌入式薄膜热电器件。
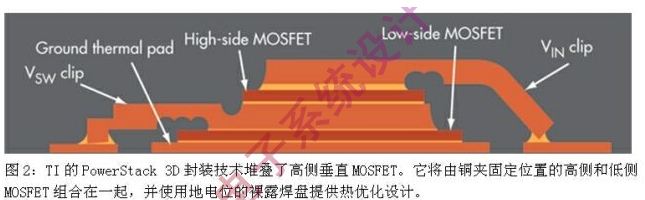
Azar构想了这样一个解决方案:最大限度地减小散热路径中的最大热阻--扩散热阻,方法是将一个散热装置直接绑定到微处理器裸片(图3)。
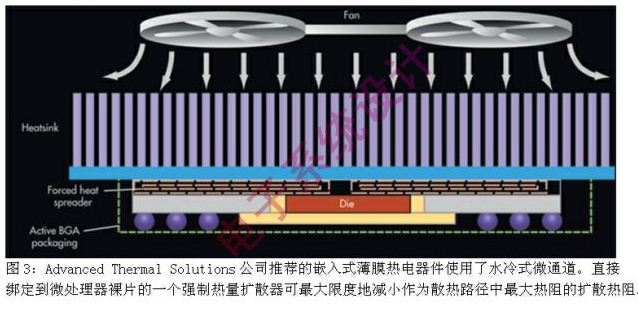
这种方法可以将小型微处理器裸片上聚集的热量发散到更大的散热器基座上,然后再将热量散发到周围环境中。这种内置强制热扩散器在硅封装中整合了微通道和迷你通道。通道内的水流速度大约为0.5至1升/分钟。
仿真结果表明,在球栅阵列(BGA)封装中的10×10mm裸片上,一个120×120mm的散热器底盘面积可以产生0.055K/W的热阻。使用热导率等于或大于钻石的散热材料可以产生0.030K/W的热阻。
Nextreme Thermal Solutions公司营销与业务发展副总裁Paul Magill也推荐热电冷却技术,并宣称应从芯片级开始冷却。该公司提供电子元件内部深度的局部热管理技术。该技术使用了名为热泵的微型薄膜热电(eTEC)结构(图4)。这种主动散热材料被嵌入倒装芯片互连(如铜柱焊锡凸块)供在电子封装中使用。

在芯片晶圆、裸片和封装级实现局部冷却可以产生重要的经济效益。例如,在拥有成千上百个先进微处理器的数据中心,这种方法的效率要比使用价格更高、体积更大的空调系统散热高得多。
| 型号 | 厂商 | 价格 |
|---|---|---|
| EPCOS | 爱普科斯 | / |
| STM32F103RCT6 | ST | ¥461.23 |
| STM32F103C8T6 | ST | ¥84 |
| STM32F103VET6 | ST | ¥426.57 |
| STM32F103RET6 | ST | ¥780.82 |
| STM8S003F3P6 | ST | ¥10.62 |
| STM32F103VCT6 | ST | ¥275.84 |
| STM32F103CBT6 | ST | ¥130.66 |
| STM32F030C8T6 | ST | ¥18.11 |
| N76E003AT20 | NUVOTON | ¥9.67 |
| 型号/产品名 | 平均报价 | 涨跌幅 |
|---|---|---|
| STM8S003F3P6 | 1.72 | 1.12% |
| 74HC573D | 0.64 | 2.86% |
| 2N7002 | 3.66 | 400.00% |
| STM32F103C8T6 | 7.47 | 27.87% |
| 1N4007 | 1.58 | 0.00% |
| ADM2483BRWZ | 8.31 | 31.36% |
| SHT10 | 16.21 | 5.88% |
| STM32F103RCT6 | 12.56 | 24.44% |
| 78L05 | 10.55 | 66.67% |
| LM358 | 118206.75 | 16.67% |
PIC16F505-I/SL 10000 件
13535226291
EM8622L-LFB 300 件
深圳福田区合芯元电子商行
EM8622L-LFB 200 件
深圳福田区合芯元电子商行
SN6505BDBVR 360 件
SN6505BDBVR 350 件